比利時微電子研究中心(imec)日前在2026年國際光學工程學會(SPIE)先進微影成形技術會議上,發表一項重要的研究成果。該研究發現,在進行EUV微影的曝光後烘烤(BEFORCE)步驟時,精準控制氣體成分有助於盡量減少所需的曝光阻劑,進而推動晶圓產量增加。其中,在更高的氧氣濃度下進行BEFORCE,持續展現更佳的金屬氧化物阻劑(MOR)劑量反應。
MOR漸漸成為先進EUV微影應用的主要技術,提供勝過化學放大阻劑(Chemically Amplified Resist)的超高解析度、更低的導線邊緣粗糙度,以及製出額定線寬尺寸的更低EUV阻劑量(Dose-to-size)。這些阻劑展現更佳的小特徵圖形與光阻薄膜轉移能力,因而成為最高解析度金屬層的潛力方案。imec的最新研究發現,在BEFORCE步驟把氧氣濃度增加到大氣含量以上,可進一步改良MOR的劑量反應。BEFORCE是EUV光阻曝光後,顯影之前的關鍵熱處理步驟。
imec資深技術研究員Ivan Pollentier表示,我們發現在曝光後烘烤時,把氧氣濃度從大氣含氧量的21%增加到50%,能夠提高15~20%的光反應速度。在模型使用的MOR和商用MOR材料都能觀察到這項趨勢。此次成果首次顯示在關鍵微影步驟仔細控制氣體成分,可以顯著減少所需的EUV曝光劑量,直接提高EUV曝光機的產量,並減少製程成本。這只是BEFORCE工具的首批成果:經過調控的氣體成分提供一種附加途徑來研究環境對MOR材料微影變異性產生影響的成因。儀器製造商可以參考這些研究見解來調整自家的製程工具,以改良EUV微影的產量與穩定性。
這些成果透過BEFORCE工具實現,這套獨特的研究工具由imec開發,目標是研究周遭環境對關鍵尺寸穩度性與MOR性能的作用。imec研發團隊負責人Kevin Dorney表示,在商用EUV機台中,完成光阻塗布的晶圓是在真空狀態下進行曝光,接著轉移到曝光後烘烤區,並在無塵室的大氣條件下進行加熱。由imec開發的BEFORCE工具模擬這些運作,但在晶圓轉移和曝光後烘烤步驟,改為在可精準調控氣體成分的環境下進行。該環境由多個氣體注入和混合系統來實現。結合整合式光反應速度量測,這項獨特的調控能力是顯現氧氣對提升MOR劑量反應所發揮作用的關鍵。
為了最大程度發揮氣體成分對MOR性能的正面影響,更深入瞭解那些在光阻劑曝光後烘烤階段發揮作用的化學機制,變得非常重要。imec正持續進行實驗來瞭解MOR性能與烘烤時化學變化觀測結果之間的關聯,這些觀測結果在多種環境條件下,透過整合式傅立葉轉換紅外光譜儀取得。未來imec將採用更先進的量測能力來擴充BEFORCE工具,取得更具影響力的研究成果。











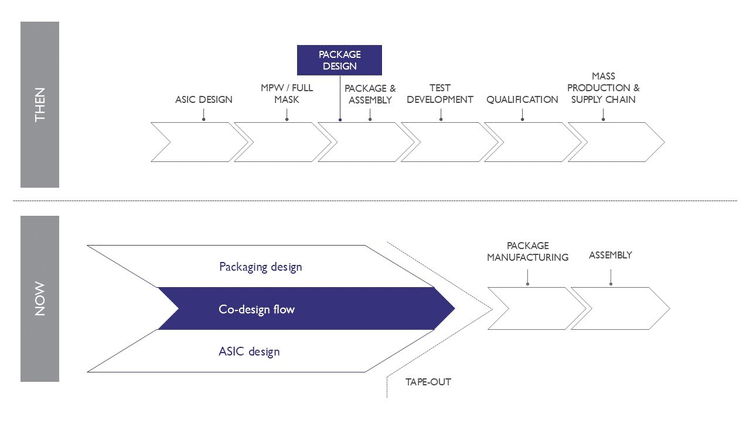















疊對之間的特徵與計算堆疊分佈、晶圓之間變化等。-e1687834743967.jpg)